/ HighTech / Atomic Force Microscope
-

-
AFM-Next
Atomic Force Microscope NEXT
Producto Descontinuado u obsoleto
Atomic Force Microscope
NEXT
multiple AFM/STM capabilities and
Main features
|
Ultimate automationAtomic Force Microscope NEXT provides motorized sample positioning and integrated high resolution optical microscope positioning, motorized continuous zoom and focusing of the optical microscope. But AFM automation is more than just motorization. Powerful Nova PX software algorithms remove a gap between optics and AFM providing continuous zoom from huge panoramic optical view down to atomic resolution.
|
Measuring techniquesCoupled with the PX Ultra controller and newest Nova PX data processing software, NEXT realizes the largest suite of AFM and STM techniques both for beginner and advanced users. NEXT provides 60+ modes and techniques in basic configuration.
|
Applications
| With its wide variety of techniques and modes of probe measurements, the NEXT measurement complex is applicable for many challenges in science and technology. Scanning with atomic resolution that by NEXT can offer is of high demand in physicochemical research of solid surfaces, low-dimensional nanostructures, and nanomaterials. Surface morphology analysis provides parameters of roughness, texture, and anisotropy of the sample surface as well as distributions of adsorbed particles and geometrical characteristics of those particles. Dedicated gentle scanning techniques are now available to study powders, soft materials, biological structures, biomolecules, biopolymers, and to perform measurements in liquid. |
A peculiar place in applications of NEXT is taken by material science. It includes study of adhesion characteristics, friction factors, wear resistance of coatings, elasticity moduli, hardness etc. Wide variety of techniques for measurement of electrical characteristics implemented in NEXT (local resistance, surface potential, capacitance, photovoltaic parameters) enables analysis of various functional structures, components of micro-, nano- and molecular electronics, and sensors of many types. NEXT offers comprehensive capabilities to study ferroelectrics in terms of their domain structure, hysteresis properties, and thermal characteristics. |
 Microporous nitrocellulose membrane
AM-AFM. Scan size 7×7 μm |
 Monodomain BFO sample PFM Phase. Scan size 3×3 μm |
 PnBA molecules on mica Adhesion map, HybriD™ mode. Scan size 300×300 nm
|
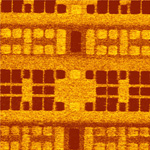 Surface Potential of SRAM
Single-pass AM-KPFM. Scan size 40×40 μm |
 |
 |
 |
 |
|
Calcite atomic resolution
AM-AFM in liquid. Scan size 7×7 nm |
Height image of the ab plane of TTF-TCNQ crystal
AM-AFM. Scan size 9×9 nm |
HOPG atomic lattice resolution
STM. Scan size 2.1×2.1 nm |
MultiScan™
on NT-MDT test sample 12 stitched AFM images. Scan size 200×200 μm |
Specifications
In air
Contact and Amplitude Modulation AFM, AFM Spectroscopy, AFM Lithography (force, current, voltage), HybriD Mode™, Spreading-Resistance Imaging, Dark mode SRI, Lateral Force Microscopy, Lateral modulation LFM, Vertical and Lateral Piezoresponse Force Microscopy, PFM Switching Spectroscopy, Force Modulation Microscopy, Magnetic Force Microscopy, Two-pass and Single-pass Electrostatic Force Microscopy, Two-pass and Single-pass Scanning Capacitance Force Microscopy, Quantitative Permittivity mapping, Two-pass and Single-pass Kelvin Probe Force Microscopy, Scanning Tunnelling Microscopy (microscopy, spectroscopy, lithography), Nanosclerometry, AFM-based nanoindentation.
In liquid
Contact and Amplitude Modulation AFM, AFM Spectroscopy, AFM Force Lithography, HybriD™ mode, Lateral Force Microscopy, Lateral modulation LFM, Force Modulation Microscopy, Magnetic Force Microscopy.
Technical data
| Measuring system | |
| Measuring heads | AFM and STM (stationary, automatically interchangeable); liquid AFM, and nanosclerometer head (removable, with manual insertion) |
| Available SPM modes | AFM, STM, nanosclerometry in air environment AFM in liquid environment |
| System of cantilever deflection registration | automated alignment |
| Sample | |
| Size | up to 20 mm in diameter, up to 10 mm in height |
| Sample weight | up to 40 g |
| Temperature control | from RT up to 150 oC |
| Scanning system | |
| Type of scanning | by sample |
| Scanning area | 100x100x10 um (with feedback sensors) 3x3x2 um in the high resolution mode |
| Nonlinearity, XY | 0.1 % (with feedback sensors) |
| Resolution | |
| Noise XY | less than 0.3 nm (with feedback sensors) |
| Noise level Z (RMS in the band of 10 -1000 Hz) | 0.03 nm (typically) with feedback sensors 0.02 nm in the high resolution mode |
| System of sample positioning | |
| Method | automated, video monitored |
| Range, XY | 5x5 mm |
| Min. step | 0.3 um |
| Video monitoring system | |
| Resolution | 2 um |
| Focus | motorized |
| Zoom | continuous |
| Overall dimensions and weight | |
| Sizing | 470x210x260 mm |
| Weight | 25 kg |


